一、QFN与DFN封装概述
DFN和QFN封装均属于无引脚表面贴装封装结构,体现出现代底部排放和顶部嵌入式封装的特征。它们具备诸多优点:体积小巧、易于集成、一致性佳,且兼具小型化、轻量化和薄型化等特点。特别值得一提的是,它们的底部通常具备出色的导热性能,能够有效散发芯片工作时产生的热量,从而显著提升芯片的可靠性和稳定性。此外,二者还都拥有良好的电气性能,信号传输路径均匀,功耗较低。
二、QFN与DFN封装的区别
(一)封装焊盘分布位置
DFN封装的焊盘分布于芯片四周,而QFN封装的焊盘则集中于芯片底部。
(二)焊接结构与底部材料
QFN封装多采用无铅焊接结构,具备低电感、低容抗等特性。其底部通常为铜质材料,导热和电性能优异,能高效散热。相比之下,DFN封装在焊接结构和底部材料方面有所不同。
(三)封装边长范围
DFN封装外形更为纤薄,常见宽度通常小于1mm,而QFN封装的边长范围一般在2 - 7mm之间。
(四)应用场景侧重
DFN封装:广泛应用于对高频、高速、高精度有需求的领域,如5G通信中的天线体,以及医疗、工业、汽车等领域的传感器、照明驱动芯片、打印机传感器等。
QFN封装:适用于功率放大器、电池充电管理芯片、自动控制设备芯片以及娱乐电子产品等,其紧凑尺寸和高集成度特性具有很高的实用性。
(五)封装形状
DFN封装管脚分布在封装体两边,整体呈矩形;QFN封装管脚分布在封装体四边,整体呈方形。
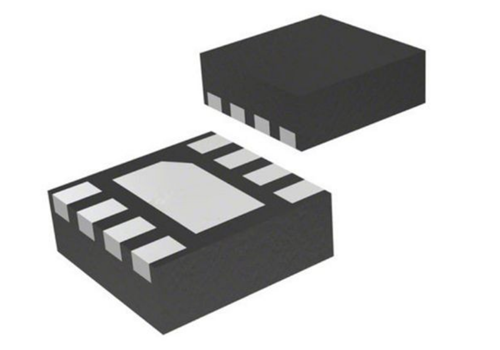

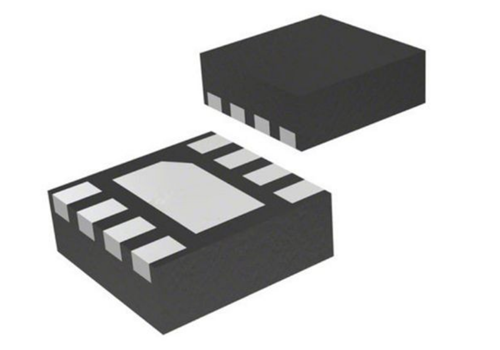

三、QFN与DFN封装工艺流程
(一)芯片切割
运用划片机等专业设备,将芯片从硅晶圆上精确切割分离。
(二)芯片贴装
把切割后的芯片粘贴到双框架芯片封装的基板上。
(三)引脚连接
借助引脚焊盘,实现芯片电路与基板电路的连接。
(四)模封加工
将双框架芯片封装在树脂等材料中,达到防水、防尘等防护目的。
(五)切边加工
对双框架芯片封装边缘进行切割,确保封装尺寸和形状符合标准。
四、QFN与DFN封装工艺制程流程
(一)基板制备
挑选合适的基板材料,并进行表面处理,如防焊处理等。
(二)芯片前处理
对芯片实施前处理工序,包括切割、磨边、去胶等操作。
(三)焊盘制备
在基板上制备焊盘,常用方法有电镀、印刷、喷涂等。
(四)芯片定位
借助自动化设备,将芯片精确定位在基板上。
(五)芯片焊接
采用热压焊、回流焊等方法,把芯片与焊盘进行焊接。
(六)后处理
对焊接后的封装进行清洗、检测、包装等一系列后续处理。
〈烜芯微/XXW〉专业制造二极管,三极管,MOS管,桥堆等,20年,工厂直销省20%,上万家电路电器生产企业选用,专业的工程师帮您稳定好每一批产品,如果您有遇到什么需要帮助解决的,可以直接联系下方的联系号码或加QQ/微信,由我们的销售经理给您精准的报价以及产品介绍
联系号码:18923864027(同微信)
QQ:709211280


