一、SiP 封装概述
系统级封装 SiP(Single In-line Package),是一种单列直插式集成电路封装技术。其引脚设计为从封装单侧引出且呈直线排列,当装配至印刷电路板时,SiP 封装呈现侧立状态。该封装技术规定引脚中心距为 2.54mm,引脚数量通常在 2 至 23 个之间,且多为定制化产品。
从功能实现角度,SiP 封装是将多个具有不同功能的有源电子元件与可选无源器件,以及诸如 MEMS 或者光学器件等其他器件进行优先组装,形成一个具有一定功能的单个标准封装件,从而构成一个完整的系统或者子系统。
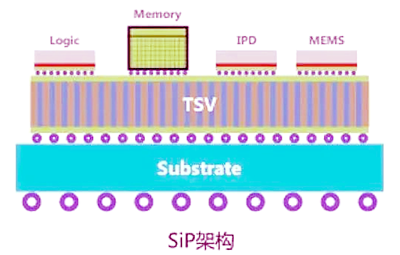
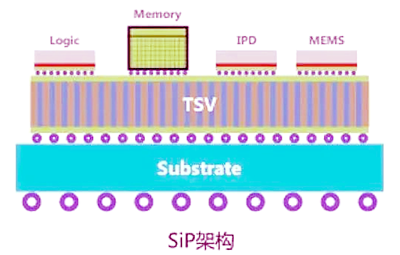
二、SiP 封装类型
依据目前业界的设计类型及结构,SiP 封装可分为三类:2D SiP、堆叠 SiP 和 3D SiP。
2D SiP 封装 :在同一个封装基板上,将芯片以二维模式一个挨一个排列,最终封装在一个封装体内。
堆叠 SiP 封装 :在一个封装中,采用物理方法将两个或多个芯片进行堆叠整合,然后进行封装。
3D SiP 封装 :在 2D 封装的基础上,将多个芯片、封装芯片、多芯片甚至圆片进行叠层互联,形成三维立体封装结构,也称作叠层型 3D 封装。
三、SiP 封装工艺
SiP 封装的核心工艺涵盖晶圆减薄、芯片贴装、互连形成和封装体构建等关键步骤。
(一)晶圆准备与减薄
原始晶圆厚度约为 700pm,需研磨至 200pm 以下,对于叠层存储芯片更是需要减薄至 50pm。该流程具体包括贴膜保护、背面研磨以及清洗环节,每一步都需谨慎操作,以防止芯片受损。
(二)芯片贴装(Die Attach)
采用银胶(环氧树脂与银粉的混合物)将芯片粘接于基板之上,同时要对温度(120°C)和压力进行精准控制,以确保芯片与基板粘接的牢固性。此过程的关键设备包括固晶机、Pick up head 等。
(三)互连技术
引线键合 (Wire Bonding) :采用传统金 / 铜线连接方式实现芯片与基板的互连。
倒装焊 (Flip Chip) :借助凸点直接连接芯片与基板,能够实现更高的连接密度。
(四)封装体构建
包括锡膏印刷、回流焊、清洗以及最终的包封保护等一系列操作。
根据芯片与基板的连接方式,SiP 封装制程主要分为引线键合封装和倒装焊封装两种类型。
四、引线键合封装工艺流程
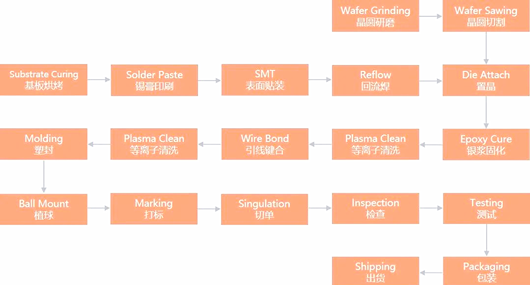
五、SiP 封装的应用领域
SiP 封装技术以其高度集成、节省空间的优势,在多个领域展现出广泛的应用前景。在消费电子领域,随着电子设备不断向小型化、多功能化发展,SiP 封装能够将多种功能模块集成在一起,满足如智能手机、平板电脑等设备对于高性能、小尺寸的要求。例如,可将处理器、存储器、射频模块等功能芯片进行 SiP 封装,从而实现设备的高速数据处理、大容量存储以及稳定的通信功能。
在物联网领域,传感器网络节点通常需要具备多种功能,如环境感知、数据处理和无线通信等,而 SiP 封装可以将微处理器、传感器、通信芯片等集成在一个小型封装内,为物联网设备的快速部署和高效运行提供有力支持。
在汽车电子方面,SiP 封装可用于车载信息系统、高级驾驶辅助系统等,将多种芯片集成封装,能够提高系统的可靠性和稳定性,同时也有助于减小汽车电子模块的体积,为汽车的智能化、电动化发展提供技术支撑。
〈烜芯微/XXW〉专业制造二极管,三极管,MOS管,桥堆等,20年,工厂直销省20%,上万家电路电器生产企业选用,专业的工程师帮您稳定好每一批产品,如果您有遇到什么需要帮助解决的,可以直接联系下方的联系号码或加QQ/微信,由我们的销售经理给您精准的报价以及产品介绍
联系号码:18923864027(同微信)
QQ:709211280


